2022-01-17 0
傳統芯片的封裝工藝始于將晶圓分離成單個的芯片。劃片有兩種方法:劃片分離或鋸片分離。對于凸點或焊球工藝,劃片是在晶圓上建立凸點或焊球系統之后。
鋸片法
較厚的晶圓使得鋸片法發展成為劃片工藝的首選方法。鋸片機由下列部分組成:可旋轉的晶圓載臺,自動或手動的劃痕定位影像系統和一個鑲有鉆石的圓形鋸片。此工藝使用了兩種技術,且每種技術開始都用鉆石鋸片從芯片劃線上經過。對于薄的晶圓,鋸片降低到晶圓的表面劃出一條深入晶圓厚度1/3的淺槽。芯片分離的方法仍沿用劃片法中所述的圓柱滾軸加壓法。第二種劃片的方法是用鋸片將晶圓完全鋸開成單個芯片。

通常,對要被完全鋸開的晶圓,首先將其貼在一張彈性較好的塑料膜上。在芯片被分離后,還會繼續貼在塑料膜上,這樣會對下一步提取芯片的工藝有所幫助。由于鋸片法劃出的芯片邊緣效果較好,同時芯片的側面也較少產生裂紋和崩角。所以,鋸片法一直是劃片工藝的首選方法。
劃片法
劃片法(scribing)或鉆石劃片法(diamond scribing)是工業界開發的第一代劃片技術。此方法要求用鑲有鉆石尖端的劃片器從劃線的中心劃過,并通過折彎晶圓將芯片分離。當晶圓厚度超過10mil時,劃片法的可靠性理論上就會降低,而近年來,已有一些企業已經逐漸攻克這一技術難題。

在精密切割設備研發和制造方面,國內走在行業第一梯隊的企業以深圳博捷芯為代表。深圳博捷芯半導體有限公司匯聚了行業精英,擁有現代化管理模式。公司擁有精密機械自動化技術、電氣自動化技術、計算機應用技術、半導體劃片工藝應用技術的研發中心,聚集了一批相關領域資深的高級專業人才和研發專家;公司采用了先進、科學、有效的現代化企業管理模式,成功建成多條完整的半導體劃片設備專用產線和一間專業的萬級凈化間劃切實驗室。
在產品力方面,目前已成功研制并量產LX6366型雙軸精密劃片機和LX3352單軸高端精密劃片機,兼容6-12英寸材料切割,設備性能均超國際標準。更建立了完善的交貨和售后保障,縮短交貨周期至3個月,而精度和穩定性是博捷芯精密劃片機的核心競爭力。

取放芯片
劃片后,分離的芯片被傳送到一個工作臺來挑選(pick)出良品。在操作中,存有良品芯片(從晶圓電測)位置信息的磁盤或磁帶被上傳到自動挑選機器。真空吸筆會自動揀出良品芯片并將其置人用在下一工序中的分區盤里。

在手動模式下,由操作工手持真空吸筆將一個個無墨點芯片取出放入到一個分區盤中。對于貼在塑料膜上進入工作臺的晶圓,首先將其放在一個框架上,此框架將塑料膜伸展開。塑料膜的伸展會將芯片分離開,這樣就輔助了下一道取片的操作。
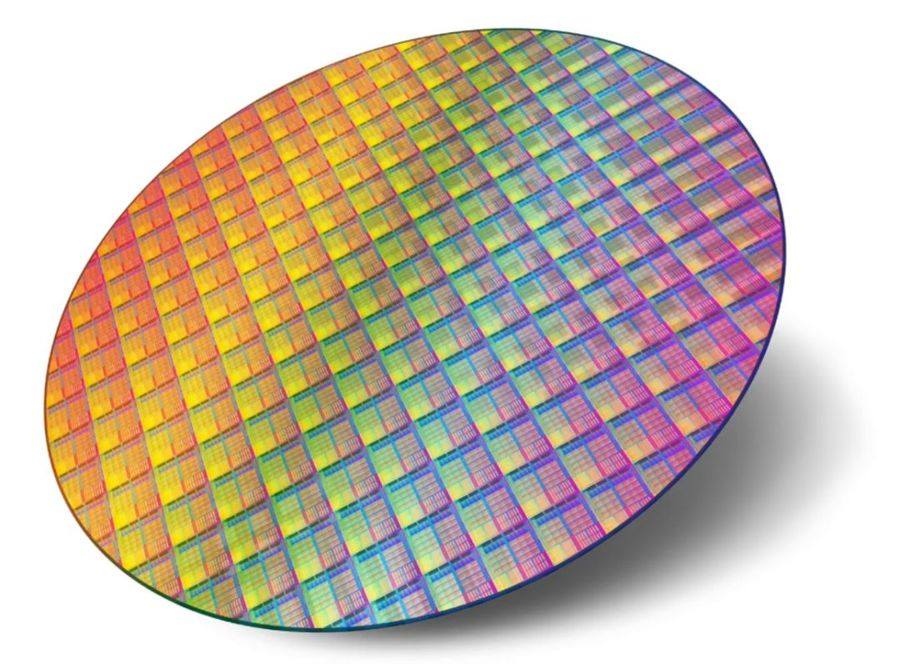
芯片精密切割關系到整個芯片的良品率,而任何劃片設備的精密程度都是由它的最終的切片晶圓的精度和良品率來決定的。歡迎有需要的各生產研發企業驗證精度,您可以把樣品提供給我司,博捷芯半導體將安排給您免費切樣,也歡迎各位到博捷芯半導體公司現場切樣。
138-2371-2890
